封装
键合玻璃载板(Glass Carrier/Substrate)是一种用于半导体封装工艺的临时性硬质支撑材料,通过键合技术与硅晶圆或芯片临时固定在一起,在特定工序(如减薄、RDL布线)完成后通过紫外光(UV)、加热或机械方式解键合移除。
先进封装已成为后摩尔时代芯片算力提升的核心手段。随着晶体管不断缩小,芯片尺寸达到光罩极限,将大芯片分割成更小的Chiplet,通过2.5D、3D堆叠打破限制便成为破局关键。
6月23日消息,X平台消息人士X86 is dead&back(@x86deadandback)北京时间昨日注意到,英特尔Nova Lake-HX(NVL-HX)处理器的VRTT测试工具出现在了第三方海关仓单数据平台NBD上。
先进封装技术企业Deca当地时间本月20日宣布与IBM签署一份协议,将Deca的M系列FOWLP封装技术和自适应图案化技术导入IBM位于加拿大魁北克省Bromont的先进封装工厂。
4月28日消息,联华电子(联电、UMC)在其本月24日公布的年度报告中提到,该企业现有规划中的最先进节点——也是其同英特尔展开合作的工艺——12nm目前开发顺利。
你要进行巨大的时间尺度(以微秒为单位),并且必须以皮秒为单位回溯时间步骤。所以这是一个巨大的模拟挑战。而且设备水平的温度依赖性并不总是完全表征的。这些设备也处于全面开发阶段,因此光子学领域存在许多变化。
与 SoC 相比,Chiplet 技术具有显著的经济优势,未来十年有望实现高增长。芯片制造商可以使用不同技术和分辨率级别的组件定制最终芯片,从而提高成品率并降低成本。
活动
2026(第五届)半导体生态创新大会
 立足前四届大会构建的产业交流生态与合作基础,中国电子商会联合多家行业机构升级打造2026(第五届)半导体生态创新大会。本届大会以“生态深度融合 创新驱动突破”为核心导向,重点展示半导体领域颠覆性技术与场景化应用成果,精准洞察产业演进新方向。围绕创新链、产业链、资金链、人才链深度融合需求,共探核心技术自主可控路径与产业协同新机制,主动破解发展瓶颈、拓展价值增长新赛道,加速科技成果向现实生产力转化,助力中国半导体产业筑牢核心竞争力,推动全球半导体产业实现更高效的资源整合与协同发展。
立足前四届大会构建的产业交流生态与合作基础,中国电子商会联合多家行业机构升级打造2026(第五届)半导体生态创新大会。本届大会以“生态深度融合 创新驱动突破”为核心导向,重点展示半导体领域颠覆性技术与场景化应用成果,精准洞察产业演进新方向。围绕创新链、产业链、资金链、人才链深度融合需求,共探核心技术自主可控路径与产业协同新机制,主动破解发展瓶颈、拓展价值增长新赛道,加速科技成果向现实生产力转化,助力中国半导体产业筑牢核心竞争力,推动全球半导体产业实现更高效的资源整合与协同发展。











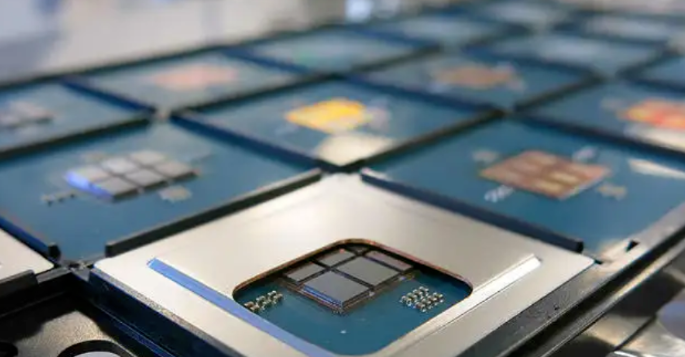
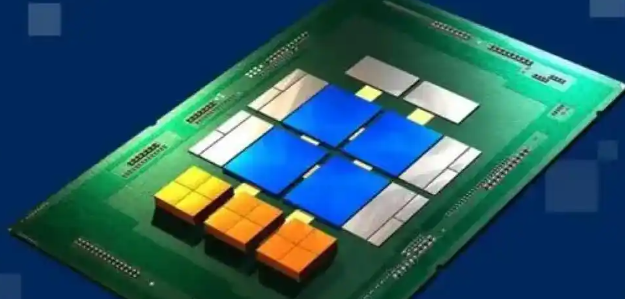

 为厘清现状、凝聚共识、探索未来,赛迪网特发起本次以“数智融合·范式跃迁”为主题的《行业数智化转型范式集(2026)》征集与调研活动。本次征集将深入研究分析,形成《行业数智化转型范式集(2026)》及《行业数智化转型生态图谱(2026)》,并在中国市场情报中心发布,同时通过官方公众号及权威媒体宣传推广。
为厘清现状、凝聚共识、探索未来,赛迪网特发起本次以“数智融合·范式跃迁”为主题的《行业数智化转型范式集(2026)》征集与调研活动。本次征集将深入研究分析,形成《行业数智化转型范式集(2026)》及《行业数智化转型生态图谱(2026)》,并在中国市场情报中心发布,同时通过官方公众号及权威媒体宣传推广。 2025-2026 “芯华奖” 以 “智驱未来,芯聚光华” 为主题,聚焦集成电路全产业链创新成果。本次活动采用线上征集形式开展,从产品技术、企业实力、生态贡献等多维度综合考察参评主体,经多轮严谨评选流程,遴选出行业关键领域的优质主体与卓越成果。本榜单旨在树立集成电路行业创新标杆、激励核心技术攻关、促进产业链上下游协同发展,彰显中国 IC 产业创新价值,为构建自主可控的集成电路产业生态、助力产业高水平自立自强提供有力支撑。现正式发布最终获奖名单。
2025-2026 “芯华奖” 以 “智驱未来,芯聚光华” 为主题,聚焦集成电路全产业链创新成果。本次活动采用线上征集形式开展,从产品技术、企业实力、生态贡献等多维度综合考察参评主体,经多轮严谨评选流程,遴选出行业关键领域的优质主体与卓越成果。本榜单旨在树立集成电路行业创新标杆、激励核心技术攻关、促进产业链上下游协同发展,彰显中国 IC 产业创新价值,为构建自主可控的集成电路产业生态、助力产业高水平自立自强提供有力支撑。现正式发布最终获奖名单。




