玻璃封装大热,TGV还有多少难题待解?

图为玻璃面板幅面(图源:RENA)
先进封装已成为后摩尔时代芯片算力提升的核心手段。随着晶体管不断缩小,芯片尺寸达到光罩极限,将大芯片分割成更小的Chiplet,通过2.5D、3D堆叠打破限制便成为破局关键。
2.5D、3D集成需要硅中介层、RDL技术、凸点、玻璃基板、TSV、TGV、混合键合技术等多项技术的配合。其中,玻璃基板封装由于其物理特性更优、封装尺寸比硅更大,电气性能更好、能够减少传输损耗,能够有效对抗翘曲问题、更适合大尺寸封装等优点,被认为是提升芯片性能的关键材料技术。
然而,这项受到业界颇多关注的技术,仍处于技术验证、预生产阶段,仍未实现批量生产。玻璃基板封装所需采用的钻孔工艺TGV(玻璃通孔)的技术成熟度则是玻璃基板技术成功与否的破局关键。
何为TGV?
为提升晶体管排布密度,优化芯片性能,垂直堆叠,3D封装需要在芯片与芯片间、晶圆与晶圆间制作垂直通孔,从而实现芯片之间的直接互连。由于芯片多是在硅基上制造,于是需要TSV(硅通孔)工艺的加持。
当前TSV工艺依据工艺顺序主要分为三种方案:
其一,先通孔,在CMOS工艺开始前制作通孔,填充材料(常用多晶硅)须耐受后续高温工艺。其二,中通孔,在CMOS器件钝化后、全局互连开始前、晶圆减薄前进行,可用铜作为填充材料。其三,后通孔,在晶圆减薄至最终厚度后进行,需将晶圆固定在载片或底部晶圆上再进行。
现阶段能够看到,不同的企业在自己的封装工艺中不同程度地采用了TSV技术。例如,台积电的CoWoS技术,通过硅中介层高密度互连芯片,采用TSV技术垂直导通转接板;英特尔的Foveros技术,水平面对面集成芯片,以TSV垂直互连实现高密度、低功耗;台积电的SoIC技术,以TSV贯穿芯片实现了无凸点键合,从而实现超高密度集成10nm以下的先进制程工艺芯片;三星的I-cube技术,基于TSV/BEOL技术,将硅中介层整合逻辑芯片与HBM,实现并行散热扩展性能。
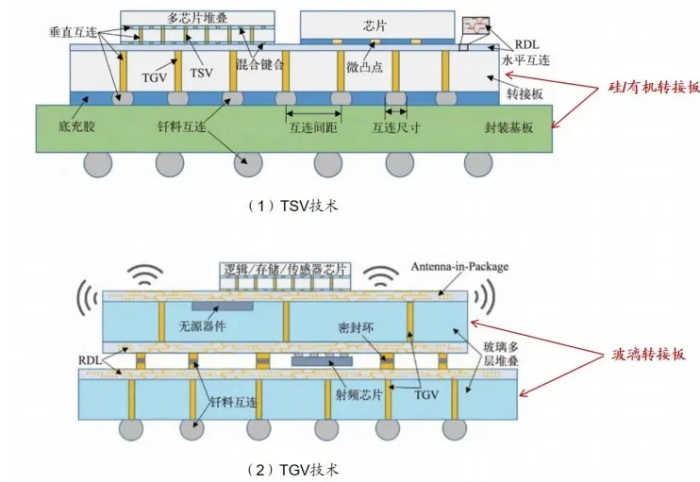
图为TSV技术与TGV技术区别(图源:广发证券发展研究中心)
而如果采用玻璃基板,则当前2.5D、3D封装中采用的硅中介层、FC-BGA载板都可以由玻璃基板替代。相应地,原先工艺中所采用的钻孔工艺也要相应地由TSV工艺转化为TGV(玻璃通孔)工艺。
TGV工艺大致包括如下流程:首先,激光钻孔会在玻璃中产生局部热应力,从而产生表面粗糙度;其次,湿法刻蚀会会扩大孔并形成TGV沟槽;随后,金属籽晶层沉积并电镀。
玻璃材料物理难题待解
在TGV领域,国内已有企业实现了技术突破。例如,沃格光电在高密度互连方面实现技术突破,通过材料改性及工艺优化,攻克了铜附着力不足、微裂纹控制及孔内填充空洞等难题,实现了3um孔径、150:1深径比、10 mm铜厚的行业领先水平,支持4层以上玻璃基板堆叠,适配AI芯片3D封装需求。云天半导体在高频集成方面实现创新,其诱导刻蚀技术,在180wm玻璃基板空腔嵌)芯片通过铜RDL布线实现77 GHz汽车雷达天线集成(AiP),2024年优化高频性能扩展至5G毫米波通信模块,提升了信号传输效率。
但玻璃材料本身的物理特征,仍然是制约玻璃基板、TGV技术在芯片封装领域普及的关键。
西北工业大学先进电子封装材料及结构研究中心教授龙旭表示,玻璃的力学性能决定了TGV封装的可靠性与应用前景。
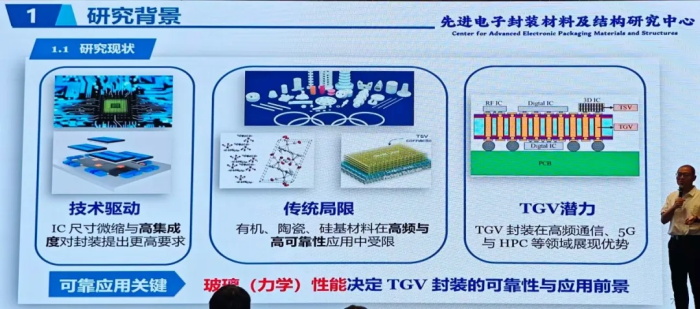
围绕这一话题,龙旭从五个层面阐释了玻璃的力学性能。
其一,在玻璃本征特性引起的力学问题层面,由于玻璃本身属于脆性材料且抗拉强度较低在温度剧烈变化的场景(如回流焊或冷热冲击测试)中会引发较大的热机械应力,这可能导致玻璃-铜界面出玻璃和金属间的热膨胀差异(CTE mismatch现分层或微裂纹问题,并导致局部乃至整体失效。
其二,从电迁移引起的力学问题层面,TGV互连结构在高电流密度下易发生电迁移(EM)失效,由干电流集中效应,主要集中于RDL-TGV交界及异质界面处,受电-热-力耦合作用加速,成为系统可靠性的关键弱环节随着电迁移时间的增加,空洞等缺陷形式可演变成裂纹,并可能扩展。
其三,在热力荷载引起的力学问题层面,玻璃基体在热载荷下会出现裂纹。TGV直径较大,易产生界面应力集中,从而显著提高裂纹敏感性;升温速率越高,径向裂纹形成概率呈指数增加,相反,低速升温有助于应力松弛并降低裂纹风险。另外,在铜互连结构与玻璃分层,材料差异导致应力失配,玻璃与铜在弹性模量和热膨胀系数上差异显著,热载荷下产生不同变形,引发界面应力集中。玻璃表面较平滑,与铜黏附性差,易在热循环中发生界面分层,严重时导致基板开裂和电路失效。
其四,在TGV-RDL(重布线层)的互连结构引起的力学和电学问题层面,TGV在低电流密度下具有较高的电学可靠性,但在大电流密度和高频应用中,容易妥到工艺缺陷和热载荷影响表现出传输性能下降。侧壁粗糙度和通孔锥度对信号完整性影响显著,粗糙度增大和锥度过大均会导致损耗、延迟及功耗增加,尤其在高频段表现突出。虽然热循环作用下TGV电阻基本保持稳定,但界面裂纹和分层会引入额外的电阻与电容效应,导致信号损耗加剧及谐振频率漂移而影响整体器件的电学性能。
其五,在制造加工方法引起的力学问题层面,由于玻璃的脆性特性,在TGV制造过程中常见的加工工艺(如激光钻孔、腐蚀、砂喷和微加工等)容易引入缺陷,主要包括微裂纹、孔周应力集中和表面粗糙度。加工工艺可能会带来芯片互连失效、界面脱粘、导体填充层断裂等潜在后果。




