为什么需要封装设计?
做过封装设计,做过PCB板级的设计,之前和网友有过交流,问题是:为什么要封装设计?信号完整性体系从大的方面来看:芯片级->封装级->板级。

能不能直径把IC,就是不经过封装设计,可以理解为晶圆Die直接放到PCB板,来实现信号的连接?
这里面需要注意两个问题:
①外界环境的影响,比如温度、湿度,以及物理受力等,这些对晶圆的性能会产生很大影响,这个如何解决?
②芯片里有大规模集成电路(Very Large Scale Integration Circuit,VLSI),有成千上万的晶体管组成,比如晶体三极管有源极、漏极、栅极三个引脚,如何将这些引脚引线到PCB板上?
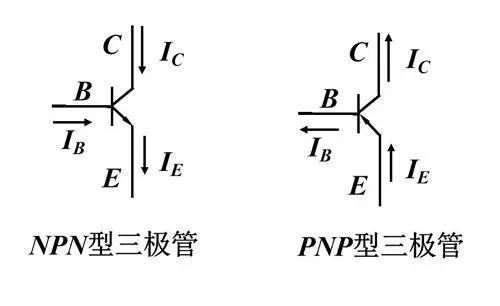
封装设计做什么?就是为了解决这些问题,实现信号更好地互连。
外部环境的问题,解决的方案是:将晶圆放到基板上,裸片的引脚通过内部连接与基板互连,通过后道塑封将其封装好后,基板再通过外部连接与外部PCB主板互连,这样就实现内部芯片与外界的连接。
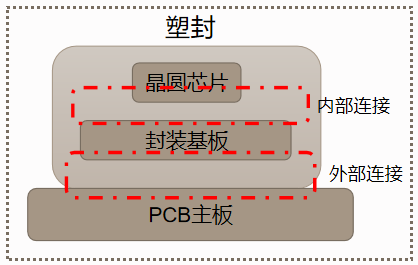
引脚的问题,比如晶体管的三极,栅极和漏极通过封装互连的相关技术,整体统一连接到栅极pad和漏极pad上,整合成的两个pad,再分别和两边的引脚相连,而源极和中间一整片引脚相连,最后进行封装。这就是我们常见的三个引脚的封装形式。
不管多复杂的封装,从本质来看,实现功能的方式都是类似的。当然,封装分立器件和封装多个具有I/O接口的IC难度是不一样。为了实现高密度集成电路的封装,发展出很多封装类型和技术,比如常见的封装互连技术有引线键合(Wire Bonding,WB)、倒装芯片(Flip Chip,FC),当然还有晶圆级封装(Wafer-Level Packaging,WLP)、以及硅通孔(Through Silicon Via,TSV)等等。
需要注意的是,同一种封装类型中也可能采用不同的互连技术,比如产品芯片里的BGA封装同时有引线键合形式和倒装形式。
不同的封装互连技术都有其优势,比如倒装芯片技术,不再通过引线实现晶圆和基板的相连,而是通过金属焊球直接实现连接,减小了信号传输的距离,提高了信号传输速度。除了信号传输距离,还有引线引入串扰的问题,也是需要关注和优化的方向。




